
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
PVT法によるAlN結晶成長
窒化ガリウム (GaN)、炭化ケイ素 (SiC)、窒化アルミニウム (AlN) などの第 3 世代のワイドバンドギャップ半導体材料は、優れた電気的、熱的、音響光学的特性を示します。これらの材料は、第 1 世代および第 2 世代の半導体材料の限界に対処し、半導体産業を大きく前進させます。
現在、その調製技術と応用技術は、SiCおよびGaNは比較的よく確立されています。対照的に、AlN、ダイヤモンド、酸化亜鉛 (ZnO) の研究はまだ初期段階にあります。 AlN は、バンドギャップ エネルギーが 6.2 eV の直接バンドギャップ半導体です。高い熱伝導率、抵抗率、絶縁破壊電界強度、および優れた化学的および熱的安定性を誇ります。その結果、AlN は青色光や紫外光の用途に重要な材料であるだけでなく、電子デバイスや集積回路に不可欠なパッケージング、誘電体分離、および絶縁材料としても機能します。特に高温および高出力のデバイスに適しています。
さらに、AlN と GaN は優れた熱的整合性と化学的適合性を示します。 AlN は GaN エピタキシャル基板としてよく使用され、GaN デバイスの欠陥密度を大幅に低減し、性能を向上させることができます。その有望な応用可能性により、世界中の研究者が高品質で大型の AlN 結晶の調製に大きな注目を集めています。
現時点での準備方法としては、AlN結晶これには、溶液法、アルミニウム金属直接窒化、水素化物気相エピタキシー (HVPE)、および物理的気相輸送 (PVT) が含まれます。中でもPVT法は、高い成長速度(最大500~1000μm/h)と転位密度10^3cm^-2以下の優れた結晶品質により、AlN結晶成長の主流技術となっている。
PVT法によるAlN結晶成長の原理とプロセス
PVT法によるAlN結晶成長は、AlN原料粉末の昇華、気相輸送、再結晶の工程を経て完了します。成長環境温度は2300℃と高温です。 PVT 法による AlN 結晶成長の基本原理は、次の式に示すように比較的単純です。 2AlN (s) =⥫⥬ 2Al (g) + N2 (g) (1)
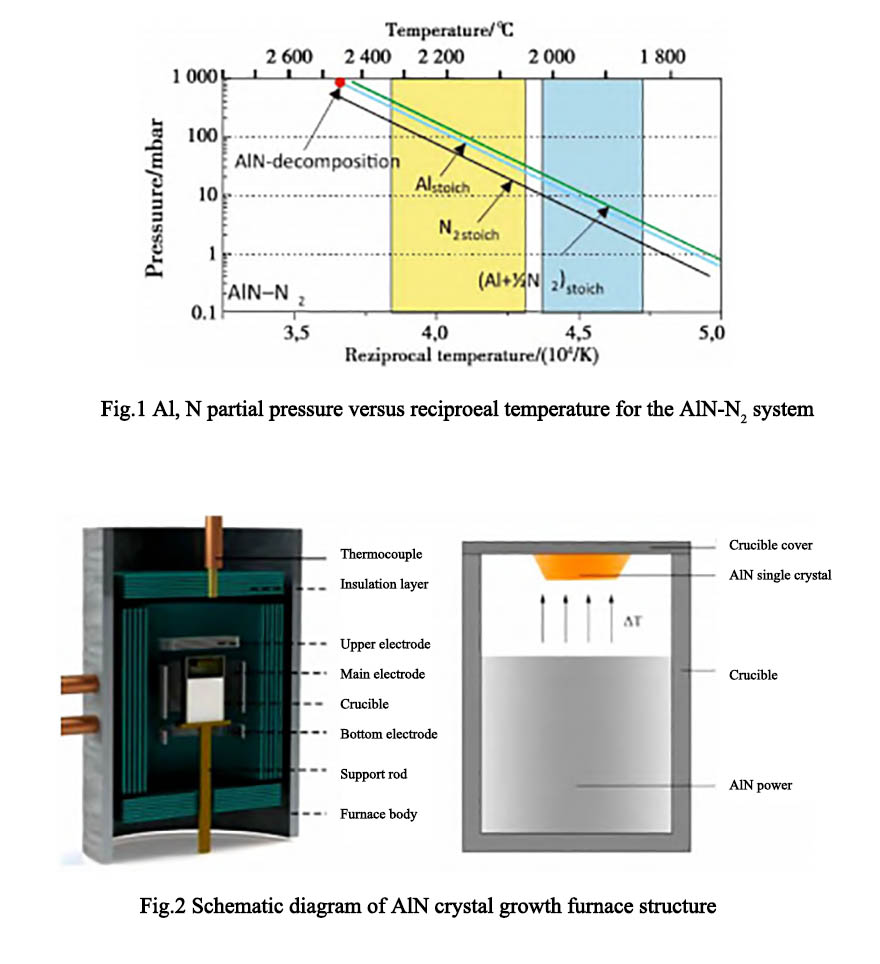
その成長プロセスの主なステップは次のとおりです。 (1) AlN 原料粉末の昇華。 (2)原料気相成分の透過。 (3)成長表面への気相成分の吸着。 (4) 表面拡散と核生成。 (5)脱着工程[10]。標準大気圧下では、AlN 結晶は約 1700 °C でゆっくりと分解して Al 蒸気と窒素になり始めます。温度が2200℃に達すると、AlNの分解反応が急激に激しくなります。図1は、AlN気相生成物の分圧と周囲温度との関係を示す曲線である。図中の黄色の領域は、PVT 法で作製した AlN 結晶のプロセス温度です。図2は、PVT法により作製したAlN結晶の成長炉構造の模式図である。
セミコレックスが提供するもの高品質るつぼソリューション単結晶育成用。ご質問がある場合、または詳細が必要な場合は、お気軽にお問い合わせください。
連絡先電話番号 +86-13567891907
電子メール: sales@semicorex.com




