
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
エッチングプロセスパラメータ
エッチングはチップ製造における重要なステップであり、シリコンウェーハ上に微細な回路構造を作成するために使用されます。これには、特定の設計要件を満たすために、化学的または物理的手段による材料層の除去が含まれます。この記事では、不完全エッチング、オーバーエッチング、エッチング速度、アンダーカット、選択性、均一性、アスペクト比、等方性/異方性エッチングなど、いくつかの主要なエッチング パラメータを紹介します。
不完全とは何かエッチング?
不完全なエッチングは、エッチング プロセス中に指定された領域の材料が完全に除去されず、パターン化された穴または表面に残留層が残る場合に発生します。この状況は、エッチング時間の不足や膜厚の不均一など、さまざまな要因によって発生する可能性があります。
以上-エッチング
必要なすべての材料を確実に完全に除去し、表面層の厚さの変動を考慮するために、通常、ある程度の量のオーバーエッチングが設計に組み込まれます。これは、実際のエッチング深さが目標値を超えていることを意味します。適切なオーバーエッチングは、後続のプロセスを正常に実行するために不可欠です。
エッチレート
エッチング速度は単位時間当たりに除去される材料の厚さを指し、エッチング効率の重要な指標となります。一般的な現象はローディング効果であり、不十分な反応性プラズマによりエッチング速度の低下や不均一なエッチング分布が発生します。これは、圧力や電力などのプロセス条件を調整することで改善できます。
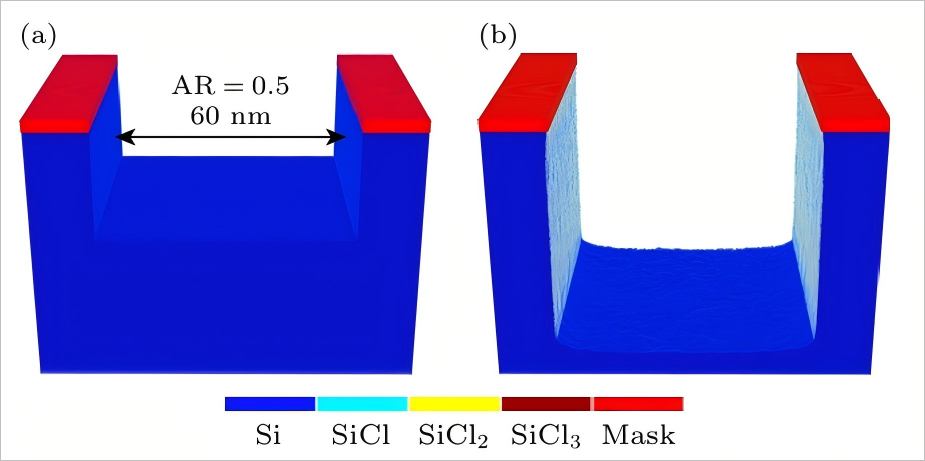
アンダーカット
アンダーカットが発生するのは次の場合です。エッチングターゲット領域内で発生するだけでなく、フォトレジストのエッジに沿って下方にも広がります。この現象により側壁が傾斜し、デバイスの寸法精度に影響を与える可能性があります。ガス流量とエッチング時間を制御することで、アンダーカットの発生を軽減します。
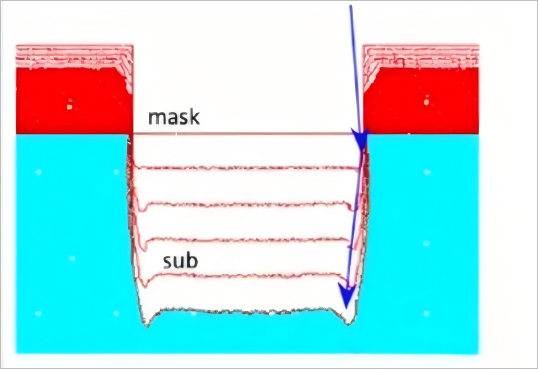
選択性
選択性は次の比率です。エッチ同じ条件下での 2 つの異なる材料間の速度。高い選択性により、どの部分をエッチングし、どの部分を保持するかをより正確に制御できます。これは、複雑な多層構造を作成する場合に重要です。
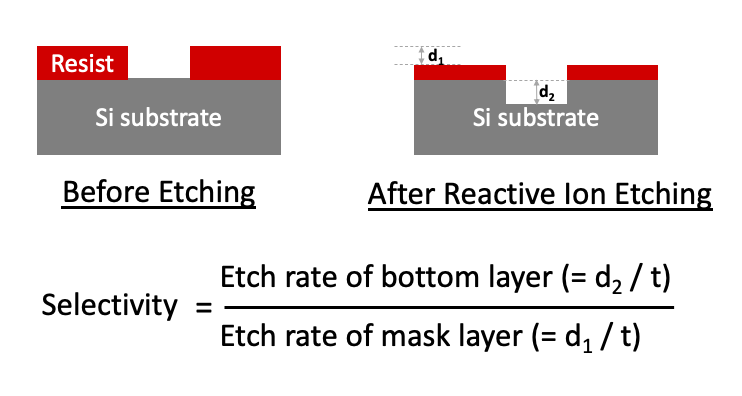
均一
均一性は、ウェーハ全体またはバッチ間のエッチング効果の一貫性を測定します。均一性が良好なため、各チップが同様の電気特性を有することが保証されます。

アスペクト比
アスペクト比は、フィーチャの高さと幅の比として定義されます。テクノロジーの進化に伴い、デバイスをよりコンパクトかつ効率的にするために、より高いアスペクト比に対する需要が高まっています。ただし、これには課題が伴いますエッチング底部の過度の浸食を避けながら垂直性を維持する必要があるためです。
等方性と異方性の仕組みエッチング異なる?
等方性エッチングあらゆる方向に均一に発生し、特定の用途に適しています。対照的に、異方性エッチングは主に垂直方向に進行するため、精密な 3 次元構造の作成に最適です。現代の集積回路製造では、形状制御を向上させるために後者が好まれることがよくあります。
Semicorex は半導体向けの高品質 SiC/TaC ソリューションを提供しますICP/PSSエッチングおよびプラズマエッチングプロセス。ご質問がある場合、または詳細が必要な場合は、お気軽にお問い合わせください。
連絡先電話番号 +86-13567891907
電子メール: sales@semicorex.com




