
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
完全な半導体デバイス製造プロセスを理解する
1. フォトリソグラフィー
フォトリソグラフィーは、多くの場合パターン生成と同義ですが、印刷における写真製版プロセスに由来する、半導体技術の急速な進歩の背後にある最も重要な原動力の 1 つです。この技術により、マイクロまたはナノスケールで任意のパターンを表示できます。フォトレジストを使用し、他のプロセス技術と組み合わせることで、これらのパターンを材料上に転写し、半導体材料やデバイスのさまざまな設計やコンセプトを実現します。フォトリソグラフィーで使用される光源はパターンの精度に直接影響します。オプションは紫外線、深紫外線、X 線、電子ビームに及び、それぞれが言及した順序でパターン忠実度のレベルの向上に対応します。
標準的なフォトリソグラフィー プロセス フローには、表面処理、接着、ソフト ベーク、露光、露光後ベーク、現像、ハード ベーク、および検査が含まれます。
通常、基板は空気中の H2O 分子を吸収するため、表面処理は不可欠です。これはフォトリソグラフィーにとって有害です。そのため、基板はまずベーキングによる脱水処理が行われます。
親水性基板の場合、疎水性フォトレジストへの接着力が不十分であり、フォトレジストの剥離やパターンの位置ずれを引き起こす可能性があるため、接着促進剤が必要になります。現在、ヘキサメチル ジシラザン (HMDS) およびトリメチル シリル ジエチル アミン (TMSDEA) が接着強化剤として広く使用されています。
表面処理後、フォトレジストの塗布が始まります。塗布されるフォトレジストの厚さは、その粘度に関係するだけでなく、スピンコーティング速度にも影響され、一般にスピン速度の平方根に反比例します。コーティング後、ソフトベークを行ってフォトレジストから溶剤を蒸発させ、プリベークとして知られるプロセスでの密着性を向上させます。
これらの手順が完了すると、露光が行われます。フォトレジストはポジ型とネガ型に分類され、露光後に反対の特性を示します。
ポジ型フォトレジストを例に挙げます。未露光のフォトレジストは現像液に不溶ですが、露光後は可溶になります。露光中、パターン化されたマスクを通過する光源がコーティングされた基板を照射し、フォトレジストをパターン化します。通常、露光位置を正確に制御するには、露光前に基板をマスクと位置合わせする必要があります。パターンの歪みを防ぐために、露光時間を厳密に管理する必要があります。露光後、定在波効果を軽減するために追加のベーキングが必要になる場合がありますが、このステップはオプションであり、直接現像を優先してバイパスすることもできます。現像により露光されたフォトレジストが溶解し、マスク パターンがフォトレジスト層に正確に転写されます。開発時間も重要です。短すぎると開発が不完全になり、長すぎるとパターンに歪みが生じます。
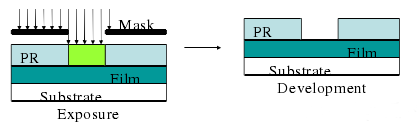
その後、ハードベークを行うことでフォトレジスト膜の基板への付着が強化され、エッチング耐性が向上します。ハード ベークの温度は通常、プリベークの温度よりわずかに高くなります。
最後に、顕微鏡検査により、パターンが期待どおりかどうかを確認します。他のプロセスによってパターンが材料に転写された後、フォトレジストはその目的を果たしたので、除去する必要があります。剥離方法には、湿式 (アセトンなどの強力な有機溶媒を使用) と乾式 (酸素プラズマを使用してフィルムをエッチング除去する) があります。
2. ドーピング手法
ドーピングは半導体技術において不可欠であり、必要に応じて半導体材料の電気的特性を変更します。一般的なドーピング方法には、熱拡散とイオン注入が含まれます。
(1) イオン注入
イオン注入では、高エネルギーのイオンを半導体基板に衝突させてドープします。熱拡散と比較して多くの利点があります。質量分析装置によって選択されたイオンは、高いドーピング純度を保証します。注入中、基板は室温またはそれよりわずかに高い温度に保たれます。二酸化ケイ素 (SiO2)、窒化ケイ素 (Si3N4)、フォトレジストなどの多くのマスキング フィルムを使用でき、自己整合マスク技術による高い柔軟性が得られます。注入量は正確に制御されており、注入される不純物イオンの分布は同一面内で均一であるため、高い再現性が得られます。
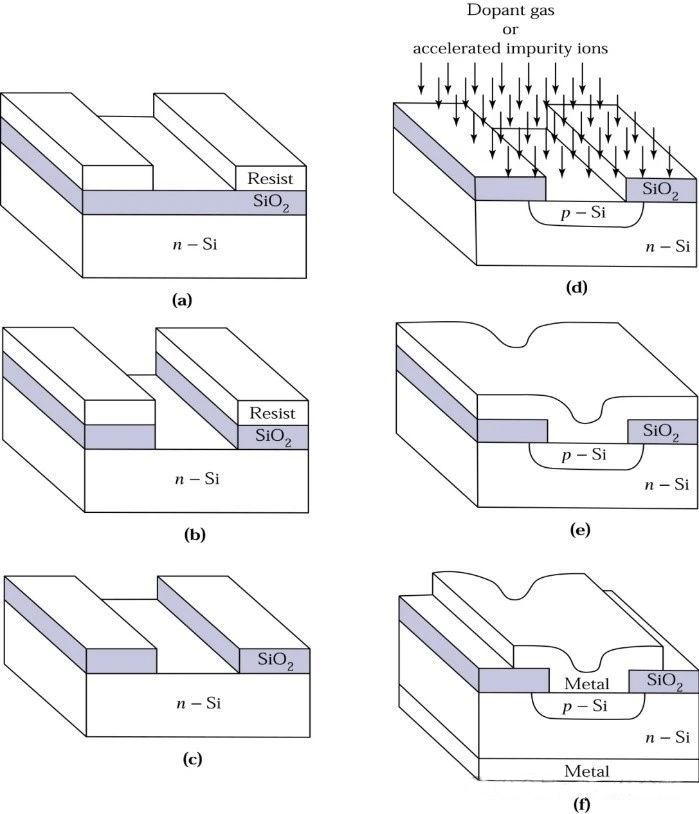
注入深さはイオンのエネルギーによって決まります。エネルギーとドーズ量を調整することにより、注入後の基板内の不純物イオンの分布を操作できます。さまざまなスキームによる複数の注入を連続的に実行して、さまざまな不純物プロファイルを達成することができる。特に、単結晶基板では、注入方向が結晶学的方向と平行である場合、チャネリング効果が発生し、一部のイオンがチャネルに沿って移動するため、深さの制御が困難になります。
チャネリングを防ぐために、注入は通常、単結晶基板の主軸に対して約 7°の角度で行われるか、基板をアモルファス層で覆うことによって行われます。
ただし、イオン注入は基板の結晶構造に重大な損傷を与える可能性があります。高エネルギーイオンは衝突すると、基板の原子核と電子にエネルギーを伝達し、それらを格子から離脱させて格子間空孔欠陥ペアを形成します。深刻な場合には、一部の領域の結晶構造が破壊され、非晶質ゾーンが形成されることがあります。
格子損傷は、キャリアの移動度や非平衡キャリアの寿命の低下など、半導体材料の電気的特性に大きな影響を与えます。最も重要なことは、注入された不純物の大部分が不規則な格子間サイトを占有し、効果的なドーピングを形成できないことです。したがって、注入後の格子損傷の修復と不純物の電気的活性化が不可欠です。
(2)急速熱処理 (RTP)
熱アニールは、イオン注入によって生じた格子損傷を修正し、不純物を電気的に活性化するのに最も効果的な方法です。高温では、基板の結晶格子内の格子間空孔欠陥ペアが再結合して消滅します。アモルファス領域も、固相エピタキシーを介して単結晶領域との境界から再結晶化します。基板材料が高温で酸化するのを防ぐために、熱アニールは真空または不活性ガス雰囲気中で実行する必要があります。従来のアニーリングには長い時間がかかり、拡散により不純物の大幅な再分布が発生する可能性があります。
の出現RTPテクノロジーはこの問題に対処し、短縮されたアニーリング時間内で格子損傷の修復と不純物の活性化を大幅に達成します。
熱源によっては、RTP電子ビーム走査、パルス電子およびイオンビーム、パルスレーザー、連続波レーザー、広帯域インコヒーレント光源(ハロゲンランプ、グラファイトヒーター、アークランプ)などのいくつかのタイプに分類され、後者が最も広く使用されています。これらのソースは基板を必要な温度まで瞬時に加熱することができ、短時間でアニールを完了し、不純物の拡散を効果的に低減します。
3. 成膜技術
(1) プラズマ化学気相成長法 (PECVD)
PECVD は膜堆積のための化学蒸着 (CVD) 技術の 1 つの形式であり、他の 2 つは大気圧 CVD (APCVD) と減圧 CVD (LPCVD) です。
現在、PECVD は 3 つのタイプの中で最も広く適用されています。高周波 (RF) プラズマを利用して比較的低温で化学反応を開始および維持するため、高い堆積速度での低温膜堆積が容易になります。装置概要は図の通りです。
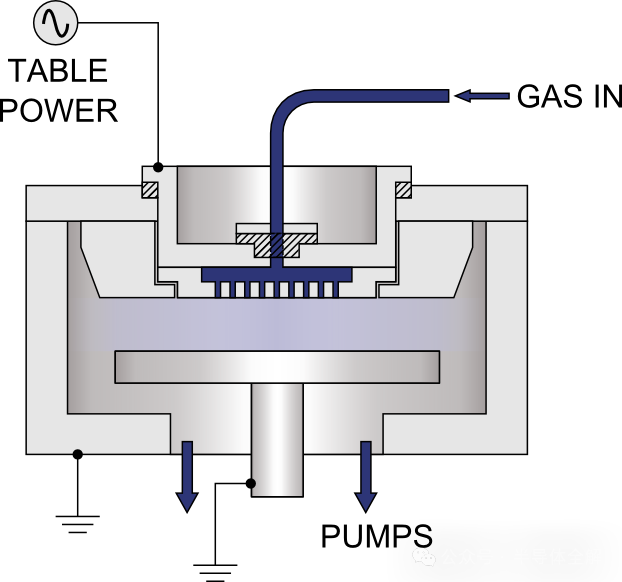
この方法で製造されたフィルムは、優れた接着力と電気特性、最小限の微細孔、高い均一性、および堅牢な小規模充填能力を示します。 PECVD 堆積の品質に影響を与える要因には、基板温度、ガス流量、圧力、RF 電力、周波数などがあります。
(2) スパッタリング
スパッタリングは物理蒸着 (PVD) 方法です。荷電イオン (通常はアルゴンイオン、Ar+) は電場で加速され、運動エネルギーを獲得します。それらはターゲット材料に向けられ、ターゲット分子と衝突し、ターゲット分子を移動させてスパッタリングさせます。これらの分子も大きな運動エネルギーを持っており、基板に向かって移動し、その上に堆積します。

一般的に使用されるスパッタリング電源には、直流 (DC) および高周波 (RF) が含まれます。DC スパッタリングは金属などの導電性材料に直接適用できますが、絶縁材料の場合は成膜に RF スパッタリングが必要です。
従来のスパッタリングでは、堆積速度が遅く、作動圧力が高いため、膜品質が低下します。マグネトロン スパッタリングは、これらの問題をより理想的に解決します。外部磁場を利用してイオンの直線軌道を磁場の方向を中心にらせん状の経路に変更し、イオンの経路を長くしてターゲット分子との衝突効率を向上させ、スパッタリング効率を高めます。これにより、堆積速度が向上し、作業圧力が低下し、膜品質が大幅に向上します。
4. エッチング テクニック
エッチングはドライ モードとウェット モードに分類され、それぞれ特定の溶液を使用する (または使用しない) ことにちなんで名付けられています。
通常、エッチングでは、エッチング対象外の領域を保護するためにマスク層 (直接フォトレジストでもよい) を準備する必要があります。
(1) ドライエッチング
一般的なドライエッチングの種類には次のものがあります。誘導結合プラズマ (ICP) エッチング、イオンビームエッチング(IBE)、および反応性イオンエッチング(RIE)。
In ICP etching, the glow discharge-produced plasma contains numerous highly chemically active free radicals (free atoms, molecules, or atomic groups), which react chemically with the target material to form volatile products, thus achieving etching.
IBE は、高エネルギー イオン (不活性ガスからイオン化されたもの) を使用してターゲット材料の表面に直接衝撃を与えてエッチングを行い、物理的なプロセスを表現します。
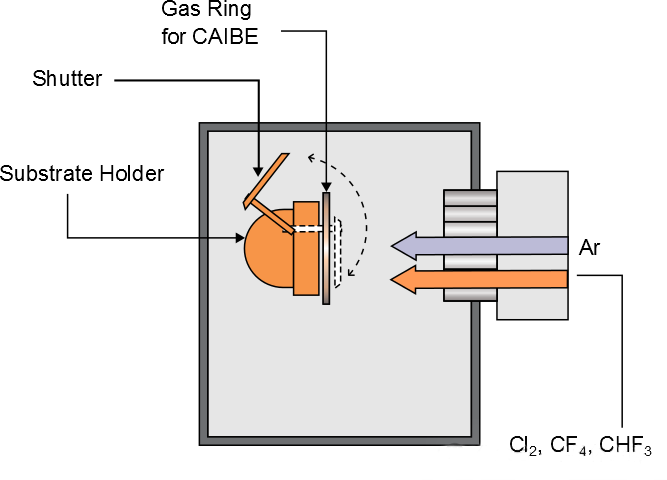
RIE は、前の 2 つを組み合わせたものと考えられ、IBE で使用される不活性ガスを ICP エッチングで使用されるガスに置き換え、RIE を構成します。
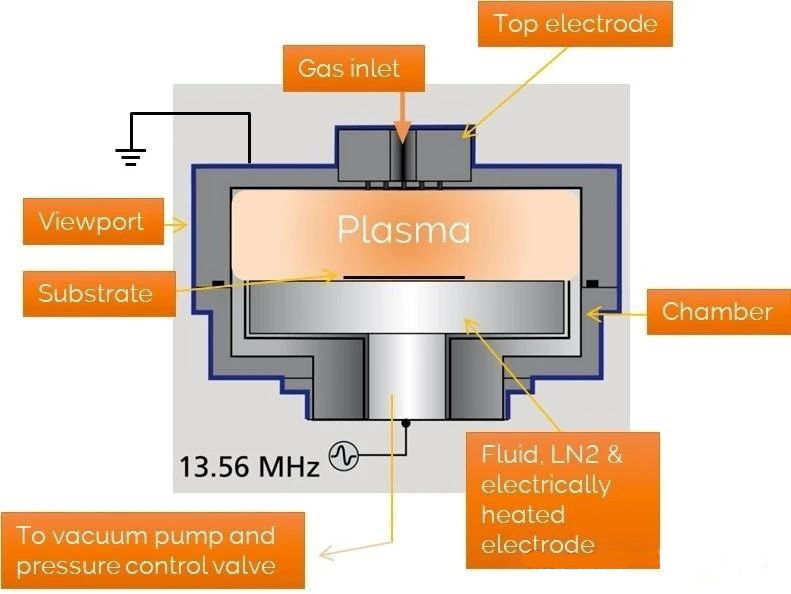
ドライエッチングの場合、垂直方向のエッチング速度が横方向の速度をはるかに上回ります。つまり、アスペクト比が高く、マスクパターンを正確に複製できます。ただし、ドライ エッチングではマスク層もエッチングされ、特に IBE では材料の表面全体が非選択的にエッチングされる可能性があるため、選択性 (マスク層に対するターゲット材料のエッチング速度の比) が低くなります。
(2) ウェットエッチング
ウェットエッチングとは、対象材料を溶液(エッチャント)に浸し、化学反応させることでエッチングを行う方法のことを指します。
このエッチング方法は簡単でコスト効率が高く、良好な選択性を示しますが、アスペクト比が低くなります。マスクのエッジの下の材料が腐食する可能性があるため、ドライ エッチングよりも精度が低くなります。低いアスペクト比の悪影響を軽減するには、適切なエッチング速度を選択する必要があります。エッチング速度に影響を与える要因には、エッチング液の濃度、エッチング時間、エッチング液の温度などがあります。**




