
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
半導体産業におけるドライエッチング技術を理解する
エッチングとは、物理的または化学的手段によって材料を選択的に除去して、設計された構造パターンを実現する技術を指します。
現在、多くの半導体デバイスはメサ デバイス構造を採用しており、主に次の 2 種類のエッチングによって作成されます。ウェットエッチングとドライエッチング。単純かつ迅速なウェットエッチングは半導体デバイスの製造において重要な役割を果たしますが、等方性エッチングや均一性の悪さなどの固有の欠点があり、その結果、小さいサイズのパターンを転写する際の制御が制限されます。しかし、ドライエッチングは、異方性が高く、均一性が高く、再現性が高いため、半導体デバイスの製造プロセスにおいて顕著になっています。 「ドライエッチング」という用語は、レーザーエッチング、プラズマエッチング、化学気相エッチングなど、表面材料の除去やマイクロおよびナノパターンの転写に使用される非ウェットエッチング技術を広く指します。このテキストで説明するドライ エッチングは、特に、プラズマ放電 (物理的または化学的) を使用して材料表面を変更するプロセスの狭い用途に関係します。以下のようないくつかの一般的な工業用エッチング技術をカバーしています。イオン ビーム エッチング (IBE)、反応性イオン エッチング (RIE)、電子サイクロトロン共鳴 (ECR) プラズマ エッチング、および誘導結合プラズマ (ICP) エッチング.
1. イオンビームエッチング(IBE)
イオンミリングとしても知られる IBE は、純粋に物理的なエッチング方法として 1970 年代に開発されました。このプロセスには、不活性ガス (Ar、Xe など) から生成されたイオン ビームが含まれます。イオン ビームは電圧によって加速され、ターゲット材料の表面に衝突します。イオンは表面原子にエネルギーを伝達し、結合エネルギーを超えるエネルギーを持つ原子をはじき飛ばします。この技術では加速電圧を利用してイオンビームの方向とエネルギーを制御するため、優れたエッチング異方性と速度制御性が得られます。セラミックや特定の金属などの化学的に安定した材料のエッチングには理想的ですが、より深くエッチングするには厚いマスクが必要になるため、エッチングの精度が損なわれる可能性があり、高エネルギーのイオン衝撃により格子破壊により避けられない電気的損傷が生じる可能性があります。

2. 反応性イオンエッチング (RIE)
IBE から開発された RIE は、化学反応と物理的なイオン衝撃を組み合わせたものです。 IBE と比較して、RIE はエッチング速度が高く、大面積にわたる優れた異方性と均一性を備えているため、マイクロおよびナノ製造において最も広く使用されているエッチング技術の 1 つとなっています。このプロセスでは、平行平板電極に高周波 (RF) 電圧を印加し、チャンバー内の電子を加速して反応ガスをイオン化し、平板の片面に安定したプラズマ状態をもたらします。電子がカソードに引き寄せられ、アノードで接地されるため、プラズマは正の電位を帯び、チャンバ全体に電界が生じます。正に帯電したプラズマはカソードに接続された基板に向かって加速し、効果的に基板をエッチングします。
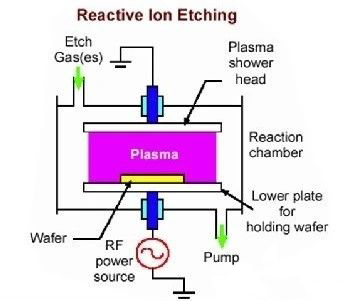
エッチングプロセス中、チャンバー内は低圧環境(0.1~10Pa)に維持され、反応ガスのイオン化率が高まり、基板表面での化学反応プロセスが促進されます。一般に、RIE プロセスでは、揮発性の反応副生成物を真空システムで効率的に除去し、高いエッチング精度を確保する必要があります。 RF 電力レベルはプラズマ密度と加速バイアス電圧を直接決定し、それによってエッチング速度を制御します。ただし、RIE ではプラズマ密度が増加する一方で、バイアス電圧も増加するため、格子損傷が発生し、マスクの選択性が低下する可能性があるため、エッチング用途に制限が生じます。大規模集積回路の急速な発展とトランジスタのサイズの縮小に伴い、マイクロおよびナノ製造における精度とアスペクト比に対する要求が高まっており、高密度プラズマベースのドライエッチング技術の出現につながり、電子情報技術の進歩のための新たな機会。
3. 電子サイクロトロン共鳴(ECR)プラズマエッチング
高密度プラズマを実現するための初期の方法である ECR 技術は、マイクロ波エネルギーを利用してチャンバー内の電子と共鳴させ、外部から印加された周波数が一致した磁場によって強化され、電子サイクロトロン共鳴を引き起こします。この方法では、RIE よりも大幅に高いプラズマ密度が得られ、エッチング速度とマスク選択性が向上するため、超高アスペクト比構造のエッチングが容易になります。ただし、マイクロ波源、RF 源、磁場の調整された機能に依存するシステムの複雑さにより、運用上の課題が生じます。 ECR を簡略化した誘導結合プラズマ (ICP) エッチングがすぐに登場しました。
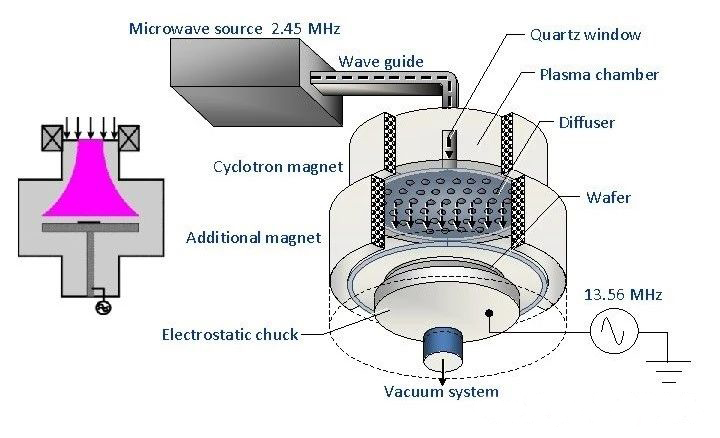
4. 誘導結合プラズマ (ICP) エッチング
ICP エッチング技術は、2 つの 13.56MHz RF ソースを使用してプラズマ生成と加速バイアス電圧の両方を制御することにより、ECR 技術に基づいたシステムを簡素化します。 ECR で使用される外部磁場の代わりに、回路図に示すように、スパイラル コイルが交流電磁場を誘導します。 RF ソースは電磁結合を通じてエネルギーを内部電子に伝達し、内部電子は誘導場内でサイクロトロン運動をし、反応ガスと衝突してイオン化を引き起こします。この設定により、ECR に匹敵するプラズマ密度が達成されます。 ICP エッチングはさまざまなエッチング システムの利点を組み合わせており、高いエッチング速度、高い選択性、大面積の均一性、およびシンプルで制御可能な装置構造のニーズを満たしているため、新世代の高密度プラズマ エッチング テクノロジにとって急速に好ましい選択肢となりつつあります。 。
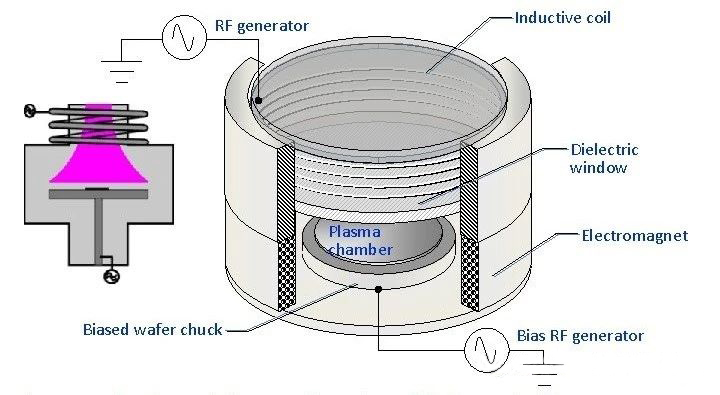
5. ドライエッチングの特徴
ドライエッチング技術は、その優れた異方性と高いエッチング速度により、ウェットエッチングに代わって、マイクロおよびナノ加工において急速に主要な地位を占めています。優れたドライエッチング技術を評価する基準には、マスクの選択性、異方性、エッチング速度、全体の均一性、格子損傷による表面の平滑性などが含まれます。多くの評価基準があるため、製造ニーズに基づいて特定の状況を考慮する必要があります。ドライ エッチングの最も直接的な指標は、エッチングされた床と側壁の平坦性、エッチングされたテラスの異方性などの表面形態です。これらはいずれも、化学反応と物理的衝撃の比率を調整することで制御できます。エッチング後の顕微鏡による特性評価は、通常、走査型電子顕微鏡や原子間力顕微鏡を使用して行われます。同じエッチング条件および時間での材料のエッチング深さに対するマスクのエッチング深さの比であるマスク選択性が重要です。一般に、選択性が高いほど、パターン転写の精度が高くなります。 ICP エッチングで使用される一般的なマスクには、フォトレジスト、金属、誘電体膜などがあります。フォトレジストは選択性が低く、高温や高エネルギーの衝撃下では劣化する可能性があります。金属は高い選択性を提供しますが、マスク除去に課題があり、多くの場合、多層マスキング技術が必要です。さらに、エッチング中に金属マスクが側壁に付着し、漏れ経路が形成される場合があります。したがって、適切なマスク技術の選択はエッチングにとって特に重要であり、マスク材料の選択はデバイスの特定の性能要件に基づいて決定する必要があります。**




