
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
LPCVD プロセスとは何ですか?
低圧化学気相成長 (LPCVD) プロセスは、低圧環境下でウェーハ表面に薄膜材料を堆積する CVD 技術です。 LPCVD プロセスは、半導体製造、オプトエレクトロニクス、薄膜太陽電池の材料堆積技術で広く使用されています。
LPCVD の反応プロセスは通常、1 ~ 10 Torr の圧力の低圧反応チャンバー内で実行されます。ウェハが堆積反応に適した温度範囲に加熱された後、ガス状前駆体が堆積のために反応チャンバーに導入されます。反応性ガスはウェーハ表面に拡散し、高温条件下でウェーハ表面上で化学反応を起こして固体堆積物(薄膜)を形成します。
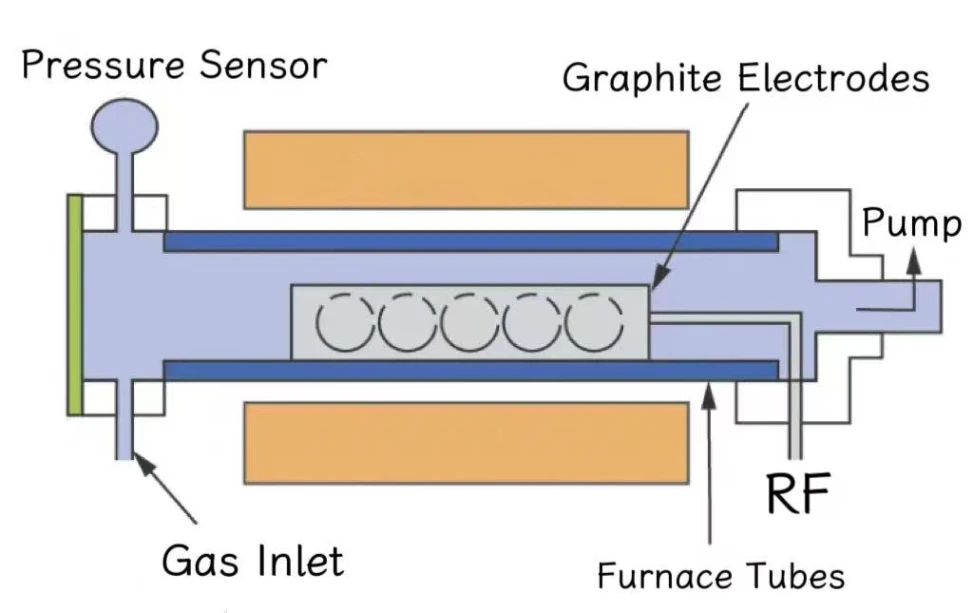
LPCVDプロセスの利点
1.高品質な成膜品質
圧力が低いとガスの拡散係数が増加するため、反応ガスの輸送速度が速くなります。したがって、ガス分子のより均一な分布が反応チャンバー全体に生成され、ガス分子がウェーハ表面と完全に反応し、不完全な反応によって生じるボイドや厚さの違いが大幅に減少します。
2.優れたこのフィルムステップカバレッジ
低圧下でガス拡散能力が向上するため、複雑な構造の奥深くまで浸透します。これにより、反応性ガスがウェーハ表面の段差やトレンチに完全に接触し、均一な薄膜の堆積が実現されます。その結果、複雑な構造上への薄膜堆積は、LPCVD 法の優れた用途となります。
3.強力な操作制御性
LPCVDプロセスは実稼働時に優れた制御性を発揮します。薄膜の組成、構造、厚さは、反応ガスの種類、流量、温度、圧力などのパラメータを調整することで正確に制御できます。 LPCVD 装置は他の蒸着技術と比較して投資コストと運用コストが比較的低く、大規模な工業生産に適しています。また、リアルタイムで監視および調整する自動化システムにより、大量生産中のプロセスの一貫性を効果的に確保できます。
LPCVD プロセスの欠点
LPCVD プロセスは通常高温で実行されるため、一部の温度に敏感な材料の適用が制限されるため、LPCVD で処理する必要があるウェーハは耐熱性が必要です。 LPCVD プロセス中に、ウェーハのラップアラウンド堆積 (ウェーハの非ターゲット領域に薄膜が堆積される) やその場ドーピングの困難など、望ましくない問題が発生する可能性があり、解決するにはその後の処理が必要です。さらに、低圧条件下での蒸気前駆体の濃度が低いと、薄膜の堆積速度が低下する可能性があり、その結果、生産効率が非効率になる可能性があります。
セミコレックスは高品質を提供しますSiCfウルナスチューブs, SiC カンチレバーパドルそしてSiCウェーハボートLPCVD プロセス用。ご質問がある場合、または詳細が必要な場合は、お気軽にお問い合わせください。
連絡先電話番号 +86-13567891907
電子メール: sales@semicorex.com





