
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
主流の剥離方法
半導体プロセスの進歩と電子部品の需要の高まりに伴い、極薄ウェーハ (厚さ 100 マイクロメートル未満) のアプリケーションがますます重要になってきています。しかし、ウェーハの厚さが薄くなるにつれて、ウェーハは研削、エッチング、メタライゼーションなどの後続のプロセス中に破損しやすくなります。
仮接合および剥離技術は通常、半導体デバイスの安定した性能と生産歩留まりを保証するために適用されます。極薄ウェーハは剛性のあるキャリア基板上に一時的に固定され、裏面処理後に 2 枚が分離されます。この分離プロセスは剥離として知られており、主に熱剥離、レーザー剥離、化学的剥離、機械的剥離が含まれます。
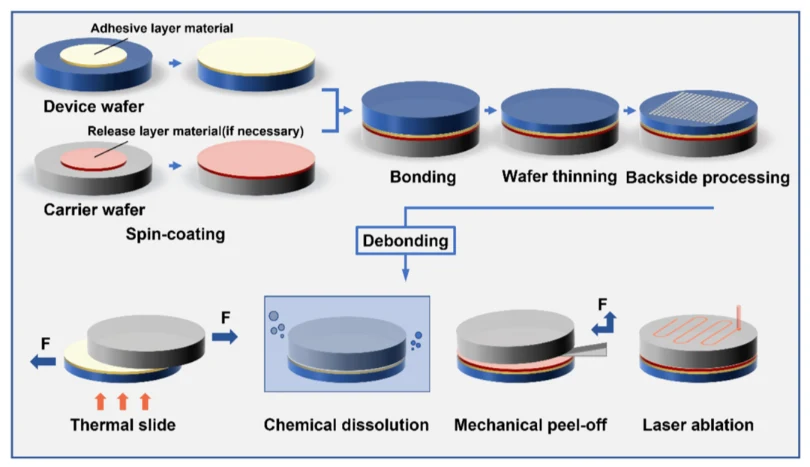
熱剥離
熱剥離は、加熱により接着剤を軟化・分解させ、接着力を失うことで極薄ウエハーをキャリア基板から剥離する方法です。主に熱スライド剥離と熱分解剥離に分けられます。
サーマルスライドデボンディングでは、通常、結合したウェーハをその軟化温度(約 190 °C ~ 220 °C の範囲)まで加熱する必要があります。この温度では、接着剤の粘着力が失われ、超薄ウェーハは、次のような装置によって加えられる剪断力によってキャリア基板からゆっくりと押されたり、剥がされたりする可能性があります。真空チャックスムーズな分離を実現します。熱分解剥離では、貼り合わせたウェーハが高温に加熱されるため、接着剤の化学分解(分子鎖の切断)が起こり、接着力が完全に失われます。その結果、機械的な力を加えることなく、貼り合わせたウェーハを自然に剥離することができます。
レーザー剥離
レーザー剥離は、貼り合わせたウェーハの粘着層にレーザーを照射して剥離する方法です。接着層はレーザーエネルギーを吸収して熱を発生し、それによって光分解反応を起こします。このアプローチにより、室温または比較的低温でキャリア基板から極薄ウェーハを分離することが可能になります。
ただし、レーザー剥離の重要な前提条件は、キャリア基板が使用するレーザー波長に対して透明である必要があることです。このようにして、レーザーエネルギーはキャリア基板をうまく透過し、結合層材料によって効果的に吸収されます。このため、レーザー波長の選択は重要です。一般的な波長には 248 nm と 365 nm があり、これらは接合材料の光吸収特性に合わせる必要があります。
化学的剥離
ケミカルデボンディングは、専用の化学溶剤で接着剤層を溶解することにより、貼り合わされたウェーハを分離します。このプロセスでは、溶媒分子が接着層に浸透して膨潤、鎖の切断、そして最終的な溶解を引き起こす必要があり、これにより極薄ウエハーとキャリア基板が自然に分離できます。したがって、追加の加熱装置や真空チャックによる機械的な力は必要なく、化学的剥離によってウェーハに生じる応力は最小限に抑えられます。
この方法では、溶媒が接着層に完全に接触して溶解できるように、キャリアウェーハに事前に穴を開けておくことがよくあります。接着剤の厚さは、溶剤の浸透と溶解の効率と均一性に影響します。可溶性接着剤は主に熱可塑性または変性ポリイミドベースの材料であり、通常はスピンコーティングによって塗布されます。
機械的剥離
機械的剥離では、熱、化学溶剤、レーザーを使用せず、制御された機械的剥離力を適用することによってのみ、一時的なキャリア基板から極薄ウェーハを分離します。このプロセスはテープを剥がすのと似ており、精密な機械操作によってウェーハがゆっくりと「持ち上げられ」ます。
セミコレックスは高品質を提供しますSIC 多孔質セラミック剥離チャック。ご質問がある場合、または詳細が必要な場合は、お気軽にお問い合わせください。
連絡先電話番号 +86-13567891907
電子メール: sales@semicorex.com




